电子元件行业
BGA(焊点)的数码显微系统下的观察、测量
随着第五代移动通信系统(5G)的普及,半导体工件的精细化、高度集成化不断发展,对产品的检测分析需求也越来越高。
下面我们将为您介绍较多使用数码显微系统进行观察的BGA(焊点)的观察、测量案例。
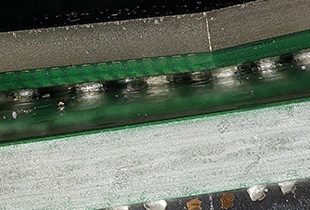
IC封装的代表性种类
随着IC的集成度的增加,表面贴装型逐渐成为主流。另外,在集成度高的IC中,使用了矩阵型(BGA型)的封装。
下述为IC封装的代表性种类。
表面贴装型:无引线型封装
- SON(Small Outline Non-leaded package)
-
 归是接触面贴装封裝,并没有引线,转变引线,有所作为接入用接线端子而常备探针衬垫。SON是2的方向分类,归是低销数用的封裝。
归是接触面贴装封裝,并没有引线,转变引线,有所作为接入用接线端子而常备探针衬垫。SON是2的方向分类,归是低销数用的封裝。 - QFN(Quad Flat Non-leaded package)
-
 是一种外表面贴装装封,不引线,所代替引线,最为接连用接线端子而常备电极片衬垫。QFN是4目标方向业务类型的装封。
是一种外表面贴装装封,不引线,所代替引线,最为接连用接线端子而常备电极片衬垫。QFN是4目标方向业务类型的装封。
表面贴装型:矩阵型封装
- BGA(Ball Grid Array)
-
 在打包封装边长确定阵列状摆列的球型焊锡球,用算作接线端子排而运用。
在打包封装边长确定阵列状摆列的球型焊锡球,用算作接线端子排而运用。 - PGA(Pin Grid Array)
-
 在芯片封装底边是以阵列状布置的销,借此有所作为端子排而用到。
在芯片封装底边是以阵列状布置的销,借此有所作为端子排而用到。 - LGA(Land Grid Array)
-
 在封口边长确定阵列状排列方式了铜等的金属电极衬垫,以此来用作绝缘端子而选用。
在封口边长确定阵列状排列方式了铜等的金属电极衬垫,以此来用作绝缘端子而选用。
贴装IC芯片的代表性接合方法
- 引线接合
-
采取金、铝、铜等细线联系半导体技术集成电线芯片的电极片部与引线框或印电线板上导体内的办法。

- 倒装芯片接合
-
直接性将IC心片接入到印类集成电线板板上的做法,被通称FC-BGA(Flip Chip-BGA)。在IC心片的工业部件生成焊点后,与印类集成电线板板侧的工业相接入。与引线黏结相对,能够做的省环境。

- 左:IC芯片
- 右:倒装(正面朝下)
倒装芯片接合的焊点形成方法的种类
- 焊球搭配法
- 将事先成型的球状焊球配置到电极上,通过回流焊形成焊点。与锡膏印刷法相比可提升焊点,对焊球的尺寸进行一定管理,能够抑制焊点高度的不均。
- 锡膏印刷法
- 将焊膏印刷到电极上,通过回流焊形成焊点。生产能力高,但是难以抑制高度的不均。
- 镀层法
- 通过电解镀层形成焊点。能够形成细微的焊点,但是生产能力低。
使用数码显微系统进行BGA(焊点)的观察、测量案例
将为您简介动用基恩士的4K数码设备显微程序“VHX编”,对BGA(焊点)实施图片检查、估测的新典型案例。

利用混合照明与消除光晕功能,
可以无光晕观察。





